Ontladingsplasma's voor productie van EUV-licht
EUV-lithografiesystemen
Een essentieel onderscheid tussen de "conventionele" systemen voor lithografie en de toekomstige systemen voor EUV-lithografie, is dat in de laatste de lenzen als optische elementen worden vervangen door multilaagspiegels. Dit is noodzakelijk omdat materialen met geschikte eigenschappen voor het maken van lenzen (transparant, en met voldoende hoge brekingsindex) bij golflengtes onder circa 150 nm niet bestaan. Vanwege het grote aantal spiegelende oppervlakken (12 of meer) en de beperkte reflectiviteit van elk oppervlak (ten hoogste 70 procent) bereikt slechts een zeer klein gedeelte van het in het EUV uitgestraalde vermogen uiteindelijk het waferoppervlak. Dit houdt in dat een EUV-lithografiesysteem een lichtbron nodig heeft die vele honderden Watts uitzendt in een nauw golflengtegebied van 2% rond 13,5 nm.
Andere vereisten bestaan uit een zekere minimale levensduur, en de "schoonheid" van de bron: dat houdt in dat vuil (zowel microscopisch als macroscopisch) en snelle deeltjes die door de bron worden geproduceerd, de levensduur van de in het systeem aanwezige optieken niet teveel mogen beïnvloeden.
Ontladingsbronnen van EUV-licht
Op het moment is er nog geen enkele bron waarvan is aangetoond dat deze aan alle vereisten voldoet. Wel wordt er onderzoek gedaan aan verschillende concepten die mogelijk verder ontwikkeld kunnen worden tot een commercieel toepasbare bron. De verschillende concepten laten zich ruwweg onderverdelen in twee hoofdgroepen: de lasergeproduceerde plasma's (LPP's) en de ontladingsplasma's.
Het onderzoek dat door de TU/e wordt uitgevoerd binnen een EUV-laboratorium van ASML, richt zich op twee verschillende typen ontladingsbronnen, namelijk de holle-kathodeontlading van Philips EUV (zie schema) en een lasergetriggerde ontlading in tindamp, ontwikkeld door het ISAN-instituut in Rusland.
 Beide bronnen zijn te beschrijven als een kortdurende ontlading (tijdsduur in de orde van enkele honderden nanoseconden) over een spanning van enkele kilovolts, met een afstand tussen de elektrodes van enkele millimeters. Ook de ontwikkeling van het plasma tijdens de puls blijkt op een vergelijkbare manier te geschieden. In beide gevallen zorgt de vele kilo-ampères sterke stroom door de ontlading voor een Lorentzkracht die het plasma doet imploderen in radiële richting, zodat een naaldvormig plasma op de symmetrie-as ontstaat. Om deze reden worden dergelijke ontladingen ook wel "pinchplasmas" genoemd.
Beide bronnen zijn te beschrijven als een kortdurende ontlading (tijdsduur in de orde van enkele honderden nanoseconden) over een spanning van enkele kilovolts, met een afstand tussen de elektrodes van enkele millimeters. Ook de ontwikkeling van het plasma tijdens de puls blijkt op een vergelijkbare manier te geschieden. In beide gevallen zorgt de vele kilo-ampères sterke stroom door de ontlading voor een Lorentzkracht die het plasma doet imploderen in radiële richting, zodat een naaldvormig plasma op de symmetrie-as ontstaat. Om deze reden worden dergelijke ontladingen ook wel "pinchplasmas" genoemd.
De belangrijkste verschillen tussen beide bronnen zijn te vinden in het werkzame element (xenon t.o.v. tin) en de manier waarop de ontlading in gang gezet wordt.
Experimentele technieken
De experimentele karakterisatie van deze bronnen geschiedt, naast het meten van spanningen, stromen en de absolute productie van EUV per puls, in de eerste plaats door het maken van tijdopgeloste opnames van het plasma in het EUV, en het bepalen van tijdopgeloste EUV-spectra. Vanwege de korte pulsduur is een tijdresolutie in de orde van 5 ns hiervoor vereist.
Door de toepassing van EUV-fotografie wordt het mogelijk een kwalitatieve beschrijving van de ontwikkeling van het plasma te geven. Als dergelijke foto's achter elkaar worden geplakt onstaat een "filmpje" van de plasmapuls.

Analyse van het EUV-spectrum leidt tot kennis over de relatieve aanwezigheid van de verschillende ionisatietrappen van het betreffende element, en, meer indirect, over de temperatuur en het soort evenwicht dat in het plasma heerst.
Meer recent zijn de genoemde diagnostieken binnen EINLIGHTRED uitgebreid met metingen aan Starkverbreding en Thomsonverstrooiing. Deze leiden tot meer kwantitatieve informatie over het plasma, in de vorm van dichtheden en temperaturen van de aanwezige deeltjes. Om de sterke achtergrondstraling van het plasma zelf te vermijden, moet bij de laatste techniek gewerkt worden met kortere laserpulsen dan gewoonlijk. Hiertoe is een nieuwe opstelling gebouwd voor het meten van Thomsonverstrooiing, waarin een camera met een sluitertijd van slechts 200 ps gesyncrhoniseerd kan worden met een laserpuls met een duur van 150 ps.
Plasma-wandinteractie
Om verliezen door absorptie in de lithografie-machine verder te beperken bevindt de hele optische trein van de machine zich in een vacuumopstelling. Toch zal het achtergrondgas gedeeltelijk geïoniseerd raken door de EUV-straling (zie de illustratie)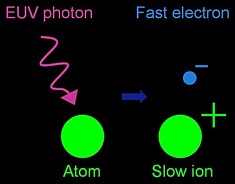 , wat leidt tot een zwak geïoniseerd plasma met een lage dichtheid (zie bijvoorbeeld de foto hieronder). De optische elementen kunnen beschadigd raken indien plasma ionen met hoge snelheid het het oppervlakte van de spiegels raken.
Een nieuwe tak van het onderzoek is daarom erop gericht om het door EUV gevormde plasma te karakteriseren met behulp van Langmuirprobe-metingen en passieve spectroscopie en om met gevoelige oppervlakte-analysetechnieken de effecten te bestuderen van het ionenbombardement op de spiegels. Om de dynamiek van het ionenbombardement beter te begrijpen is een kinetisch plasmamodel ontwikkeld. Met dit Particle-In-Cell Monte-Carlomodel kunnen voorspellingen worden gedaan aangaande de flux en energieën van de ionen. In de nabije toekomst zal het onderzoek zich toespitsen op het bepalen van de energie waarbij ionen de spiegels beginnen te beschadigen.
, wat leidt tot een zwak geïoniseerd plasma met een lage dichtheid (zie bijvoorbeeld de foto hieronder). De optische elementen kunnen beschadigd raken indien plasma ionen met hoge snelheid het het oppervlakte van de spiegels raken.
Een nieuwe tak van het onderzoek is daarom erop gericht om het door EUV gevormde plasma te karakteriseren met behulp van Langmuirprobe-metingen en passieve spectroscopie en om met gevoelige oppervlakte-analysetechnieken de effecten te bestuderen van het ionenbombardement op de spiegels. Om de dynamiek van het ionenbombardement beter te begrijpen is een kinetisch plasmamodel ontwikkeld. Met dit Particle-In-Cell Monte-Carlomodel kunnen voorspellingen worden gedaan aangaande de flux en energieën van de ionen. In de nabije toekomst zal het onderzoek zich toespitsen op het bepalen van de energie waarbij ionen de spiegels beginnen te beschadigen.
Foto onder: visualisatie van een gefocusseerde EUV-bundel door het oplichten van achtergrond-stikstofgas.

Verder lezen
Over de karakterisatie van de EUV-bronnen is reeds een aantal publicaties verschenen. Onderstaande artikelen (alle in pdf-formaat, en in het Engels) beschrijven de verschillende aspecten.
De resultaten van de laatste experimenten met "sub-nanoseconde" Thomsonverstrooiing zullen hier later worden toegevoegd.
by Erik Kieft
 Beide bronnen zijn te beschrijven als een kortdurende ontlading (tijdsduur in de orde van enkele honderden nanoseconden) over een spanning van enkele kilovolts, met een afstand tussen de elektrodes van enkele millimeters. Ook de ontwikkeling van het plasma tijdens de puls blijkt op een vergelijkbare manier te geschieden. In beide gevallen zorgt de vele kilo-ampères sterke stroom door de ontlading voor een Lorentzkracht die het plasma doet imploderen in radiële richting, zodat een naaldvormig plasma op de symmetrie-as ontstaat. Om deze reden worden dergelijke ontladingen ook wel "pinchplasmas" genoemd.
Beide bronnen zijn te beschrijven als een kortdurende ontlading (tijdsduur in de orde van enkele honderden nanoseconden) over een spanning van enkele kilovolts, met een afstand tussen de elektrodes van enkele millimeters. Ook de ontwikkeling van het plasma tijdens de puls blijkt op een vergelijkbare manier te geschieden. In beide gevallen zorgt de vele kilo-ampères sterke stroom door de ontlading voor een Lorentzkracht die het plasma doet imploderen in radiële richting, zodat een naaldvormig plasma op de symmetrie-as ontstaat. Om deze reden worden dergelijke ontladingen ook wel "pinchplasmas" genoemd.
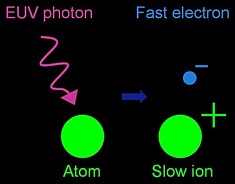 , wat leidt tot een zwak geïoniseerd plasma met een lage dichtheid (zie bijvoorbeeld de foto hieronder). De optische elementen kunnen beschadigd raken indien plasma ionen met hoge snelheid het het oppervlakte van de spiegels raken.
Een nieuwe tak van het onderzoek is daarom erop gericht om het door EUV gevormde plasma te karakteriseren met behulp van Langmuirprobe-metingen en passieve spectroscopie en om met gevoelige oppervlakte-analysetechnieken de effecten te bestuderen van het ionenbombardement op de spiegels. Om de dynamiek van het ionenbombardement beter te begrijpen is een kinetisch plasmamodel ontwikkeld. Met dit Particle-In-Cell Monte-Carlomodel kunnen voorspellingen worden gedaan aangaande de flux en energieën van de ionen. In de nabije toekomst zal het onderzoek zich toespitsen op het bepalen van de energie waarbij ionen de spiegels beginnen te beschadigen.
, wat leidt tot een zwak geïoniseerd plasma met een lage dichtheid (zie bijvoorbeeld de foto hieronder). De optische elementen kunnen beschadigd raken indien plasma ionen met hoge snelheid het het oppervlakte van de spiegels raken.
Een nieuwe tak van het onderzoek is daarom erop gericht om het door EUV gevormde plasma te karakteriseren met behulp van Langmuirprobe-metingen en passieve spectroscopie en om met gevoelige oppervlakte-analysetechnieken de effecten te bestuderen van het ionenbombardement op de spiegels. Om de dynamiek van het ionenbombardement beter te begrijpen is een kinetisch plasmamodel ontwikkeld. Met dit Particle-In-Cell Monte-Carlomodel kunnen voorspellingen worden gedaan aangaande de flux en energieën van de ionen. In de nabije toekomst zal het onderzoek zich toespitsen op het bepalen van de energie waarbij ionen de spiegels beginnen te beschadigen.